Method Article
使用激光扫描显微镜测定二硅化钼中的电迁移
摘要
在这里,我们描述了一种使用激光扫描显微镜来确定通过被测金属线的电迁移体积的工作流程。通过改变不同的实验变量,可以获得有关电迁移的大量信息。在这项工作中,确定了电迁移开始的长度。
摘要
随着电流密度的增加和芯片尺寸的减小,电迁移变得越来越重要。电迁移是由电流流动引起的导电材料中原子的运动。对于铝和铜,电迁移参数及其依赖关系已经被许多人和方法研究过。对于其他材料,情况并非如此。电迁移实验通常需要很长的时间来对中位至失效实验中的被测线施加压力。这些实验仅提供有关电迁移的表面信息。更复杂的方法着眼于微观或纳米尺度的影响和影响。通常,这些研究使用昂贵的设备,如扫描电子显微镜 (SEM)、同步加速器或 X 射线显微断层扫描。已经开发了一种工作流程,能够使用激光扫描显微镜在微观尺度上研究电迁移。使用这种激光扫描技术,可以获得比 SEM 略低的精度的结果,但制备样品的工作量要少得多。
在已知电迁移体积的情况下,可以使用与通过 SEM 测定的电迁移体积相同的程序来计算电迁移参数。通过改变不同的实验变量,可以获得有关电迁移的大量信息。在这项工作中,显示了确定电迁移开始的长度。
引言
电迁移是由电流引起的金属离子迁移。在电迁移过程中,力  作用在金属离子上。
作用在金属离子上。
在没有封装层的被测导电线内对离子的力  可以计算为:
可以计算为:

其中 Z* 是离子移动的有效离子电荷,是电子的电荷,  是电场1。
是电场1。  对于比电阻率 ρ 和电流密度
对于比电阻率 ρ 和电流密度  .
.
Z* 取决于离子种类和被测线的材料。它的值表示电迁移的强度,它的符号表示相关离子的运动方向。
这个力导致原子移动并在金属线中传输。使用离子速度和  驱动力
驱动力  之间的关系以及离子
之间的关系以及离子  迁移率的 Nernst-Einstein 关系,原子通量(通过电迁移传输的单位时间、单位面积的原子数)
迁移率的 Nernst-Einstein 关系,原子通量(通过电迁移传输的单位时间、单位面积的原子数)  可以计算为:
可以计算为:

其中 N 是晶格原子的密度,扩散系数 D,k 是玻尔兹曼常数,T 是绝对温度2。
电迁移体积可以描述为 2,3,4:
V = ΩJEM在
其中 A 是导体的横截面积,Ω 是原子体积,t 是电迁移的时间。
对于被测的封装线路,必须考虑取决于机械应力的附加组件:

其中σ xx 是沿样品长度的法向应力,x 是沿被测线长度的坐标1。正如其他出版物中所示,这导致了5:

电迁移产生应力是被测固态线中众所周知的现象。
如果  = 0 则质量传递
= 0 则质量传递  = 0(并且 V = 0),电迁移开始时长度 l 和电流密度的临界乘积可以与材料参数相关,如下所示1:
= 0(并且 V = 0),电迁移开始时长度 l 和电流密度的临界乘积可以与材料参数相关,如下所示1:

这种关键产品在电子元件或电路的设计中非常重要,因为长度短于临界长度的线路(也称为 Blech 长度)是永恒的。在下面的实验步骤中,显示了 (Ij)c 的测定。如果其他参数已知,则可以计算 Z* 作为重要材料量。
以前发表的电迁移体积测量方法使用 SEM、透射电子显微镜 (TEM) 或 X 射线显微断层扫描 (X)3,4,6,7,8,9。
使用这些仪器涉及样品的精细制备,例如在具有高电阻率的表面上涂上额外的金属薄膜,以减少电子束扫描过程中表面电荷的积累。
表面上的附加层可能会导致问题,例如通过改变界面处的机械应力来改变电迁移行为。另一方面,电荷积累会导致扫描过程中样品的虚拟漂移,使数据变得毫无用处。
SEM、TEM 的作也比使用激光扫描显微镜更耗时、更昂贵。激光扫描显微镜的使用有助于在较高温度下研究被测线。对于 SEM,还存在一些并非所有 SEM 都容易获得的加热台,这些加热台价格昂贵,并且通常是定制的。
使用激光扫描显微镜,体积的测量不确定度可以与 SEM 相同,前提是使用适当的设备并仔细注意测量条件。
在表面扫描过程中,每个点都会测量多个值,从而获得高分辨率。由于激光扫描显微镜的扫描原理,该方法的极限不等于衍射极限。这使得能够测量横向尺寸约为 120 nm 的结构。
与 SEM 测量相比,可以更轻松、更精确地测量结构的高度,而且工作量要少得多。使用 SEM 确定高度可能需要在用聚焦离子束 (FIB) 准备几个交叉点后测量这些交叉点的高度。FIB 会在附近造成磨损。由于这些准备工作,SEM 测量可能无法充分表示空隙或小丘的体积,导致两种方法的体积测量具有相似的精度。
由于在环境空气条件下运行,因此比使用 SEM 或 TEM 可以更快、更便宜、更通用地运行。
如果可以避免测量过程中材料的氧化,则可以使用此处描述的方法。由于被测管路的自热,在高温下可能会发生氧化。否则,建议使用 SEM 或扫描被测线,先扫描感兴趣区域的几何形状,然后在真空室中施加电迁移应力,最后第二次扫描被测线感兴趣区域的几何形状。
如果样品在不同的环境中移动以进行应力,则必须注意在应力之前和之后将样品对准同一方向。对齐无需校正扫描的图像以进行车削。这通常比通过软件校正转弯更准确。
该方法使用准备好的样品,包括初始激光扫描,在预定条件下对样品进行应力处理,并对相同区域进行第二次激光扫描。从这些扫描中,通过减去两个激光扫描来确定几个样品的电迁移体积。使用多个样品的体积数据,确定不同长度的最佳拟合线的截距。此截距是实验中使用的条件下的 Blech 长度。该方法在研究具有高电阻率的导电材料或受其他方法所需的样品制备负影响的材料时具有优势。
电迁移测试的被测线的几何形状因所使用的测量技术而异。激光扫描显微镜的使用不仅限于宽度为几微米10 的单条被测线,还可用于研究电迁移引起的体积变化的所有结构,例如 Blech 结构。
研究方案
1. 选择材料并制作目标材料的待测线
- 选择感兴趣材料的被测线并组装这些线,以使用激光扫描显微镜进入被测线的感兴趣区域。
注意:被测线可能具有用于尖端半导体的几何形状,或者可能更大并且仅用于评估电迁移现象。线的几何形状可能但不限于 20-50 μm 的宽度、10 nm 至 200 nm 的厚度以及 40 μm 至 800 μm 的长度。感兴趣区域取决于所使用的材料和测试结构的几何形状,这必须通过在第一次实验中使用强应力条件扫描整个测试结构来确定。测试结构中显示体积变化的所有部分都可以用作感兴趣区域。 - 使用由相同材料制成的封装或未封装的被测线,具有相同的横截面(相同的高度和宽度),但长度不同。使用相同的条件 (电流密度、温度、气氛、时间) 对它们进行应力处理,以确定电迁移开始的临界长度。
- 或者,使用相同长度的被测线路,并在小范围内改变电流密度,同时在相同气氛中以相同温度施加应力。
2. 确定电迁移体积
- 根据协议的后续步骤确定不同长度(多个数据点)或不同电流密度的电迁移体积,这些步骤详细描述了如何获得单个数据点。
注意:使用本出版物中包含的方法,每个样本都用于获取一个数据点。 - 获取 1 个数据点
- 使用具有最高分辨率的激光扫描显微镜。
注意:并非所有激光扫描显微镜都能达到本协议中包含的方法所需的分辨率。 - 打开激光扫描显微镜并打开测量和分析软件。如果测量软件询问 Return to the XY stage origin? 单击 No。
- 获取样品和合适的样品架,以便能够将样品固定在激光扫描显微镜的载物台上,这样样品在扫描过程中就不会移动。
- 获取准确的电流源和电线以进行电气连接。确保电流源和电缆正常工作。
- 改变激光扫描显微镜载物台的高度,将样品放在激光扫描显微镜下方的样品架中。将样品平行于显微镜的工作台对齐。固定样品,使其在测量过程中不会移动。
注意:此时可以暂停实验。有时,样品的行为会根据储存条件而变化,例如,由于氧化。暂停是可选的,如果预计样品会随着这些测量的条件而发生很大变化,则应避免暂停。 - 根据设置,将电流源的电源插座连接到样品或样品架。通过短时间使用小电流或通过光学检查检查键合丝是否仍然连接到样品上。
注意:此时可以暂停实验。 - 调整激光扫描显微镜的物镜与样品之间的高度差,以使样品聚焦。以最低放大倍率将感兴趣区域置于物镜的焦点上。可以手动作,也可以在测量软件的 Observe 窗口中单击 Auto focus。
注意:如有必要,请移动工作台的 XY 位置,以便能够看到感兴趣的区域。此时可以暂停实验。 - 将物镜更改为下一个更高的放大倍率,并专注于感兴趣的区域。手动或在软件的 Observe 窗口中单击 Auto focus。
注意:此时可以暂停实验。 - 重复更换物镜和聚焦,直到使用具有最高放大倍率的物镜(例如在 观察 窗口中的 150 倍)可以看到聚焦的感兴趣区域。
注意:如果感兴趣区域大于能够使用激光扫描显微镜最精确设置进行扫描的区域,请使用拼接。该协议不包括如何进行拼接的解释。此时可以暂停实验。 - 确保 Tools > Measure > Average count (测量平均计数 ) 设置为 4。单击 选项 > 自动保存 “,选择保存目标文件夹、文件名前缀和文件名样本,然后单击 确定 。
- 转到 Measure 窗口。选择 Expert Mode(专家模式)。使用 “测量”设置>“表面轮廓”>超精细 (2048 x 1536) >高精度。
注意:如果使用其他激光扫描显微镜,则获得最高精度的设置名称可能会有所不同。 - 通过单击 向上 箭头来增加物镜和样品之间的距离,直到整个窗口显示表面为黑色。单击 Set upper pos (设置上部位置)。通过单击 向下 箭头直到整个表面可见来减小物镜和样品之间的距离,然后继续单击 向下箭头 ,直到显示表面的整个窗口为黑色。单击 Set lower pos(设置较低位置)。
- 单击 Auto gain 和 Start measurement 开始扫描感兴趣区域的表面。
注意:在使用材料和设置的第一个实验中,不仅扫描感兴趣区域,而且扫描被测线的所有表面,从一个电触点(例如,键合线)到样品的另一个触点(键合线),再到仅用于将样品连接到周围环境的第一部分,以便能够确定构成新体积的原子的来源它们可以来自样品的不同部分,并排除不同的效应,例如导致体积出现的热迁移。此时可以暂停实验。 - 在对样品施加压力之前,通过多次单击 向上箭头 ,将物镜与样品之间的距离增加几毫米至 1 厘米,使激光扫描显微镜散焦。
注意:这是为了避免损坏物镜。根据被测线路的材料和应力条件,被测线路会发热。在某些情况下,温度会达到几百摄氏度。在激光扫描过程中,物镜和样品之间的距离通常短于 2 mm。如果在应力期间不增加距离,物镜在实验过程中会显着升温。加热物镜会导致镜头中产生机械应力,这可能导致镜头变形或镜头的其他损坏。 - 用预定条件 (电流密度、时间) 对样品进行应力处理。在预定时间后停止电流。
注意:条件包括电流密度、应力时间、温度和被测线路的长度。应力条件取决于感兴趣的材料。此时可以暂停实验。 - 当前应力后等待 3-5 分钟。样品冷却至室温 (RT) 后,将激光扫描显微镜聚焦在感兴趣区域。
注意:此时可以暂停实验。 - 再次聚焦,直到样品停止自行散焦,以确保不会因温度变化而在测量表面出现漂移。
注意:此时可以暂停实验。 - 根据步骤 2.2.10-2.2.13,使用相同的设置扫描当前应力之前扫描的相同区域。
注意:此时可以暂停实验。 - 使用分析软件并校正感兴趣区域的两张图像。
- 如果未打开文件,请在分析软件中打开该文件,方法是单击 File > Open 并搜索正确的文件。
- 通过单击 Process image(处理图像) 来校正样品的倾斜>Correct tilt(校正倾斜)以打开一个用于校正倾斜的窗口。使用 显示图像激光 + 光学 和校正方法 平面倾斜(3 点) 使三个点出现在显示的图像中。
- 移动线条时,每条线条中的大多数都位于背景中。将三个点移动到靠近感兴趣区域的位置。移动这些点以将平面 (由横截面中的两条直线表示) 与背景匹配。
注意:如果背景没有用平面正确表示,请将平面与感兴趣区域的下边缘匹配。 - 选择 Do not adjust offset height 0 data (不调整偏移高度 0 数据 ) 和 Auto adjust height range (自动调整高度范围 ),然后单击 Execute and Close ( 执行 并 关闭)。
- 通过单击 Process image > Height cut level 打开高度切割窗口,删除由激光扫描显微镜过载引起的高度。将剪切级别设置为 Normal(正常),使用 Always compliment height 0 data(始终补充高度 0 数据),然后单击 OK(确定)。
注意:此时可以暂停实验。 - 如果图像大于感兴趣区域并且太大而无法使用用于评估的软件进行评估,请修剪图像。修剪图像,使感兴趣区域位于中心,例如 500 像素 x 500 像素。
- 通过单击进行修剪 处理图像 > 修剪 以打开修剪窗口。根据感兴趣区域选择宽度和高度,然后移动矩形以进行选择以包含感兴趣区域。
注意:理想的情况是,通过完美对齐样品来校正图像,这样它们就不会在样品台上倾斜,并且只扫描样品中略大于感兴趣区域的一部分。使用可用的设备可能无法进行这种理想的测量类型。
- 保存校正后的裁切图像。通过单击文件 >打开 并选择正确的文件,使用分析软件打开校正和修剪的图像。
- 要以某种方式导出数据以保留有关感兴趣区域的 3D 信息,例如,作为 ASC 文件,请使用以下步骤。单击 File > Output 3D-CAD data 打开用于选择输出参数的窗口。
- 使用 跳过量 1(无跳过)>实际数字显示精度 10 > XY 缩放率 x1 和 增强高度 (%) 100 ,然后选择 表面 或使用具有最高准确度的选项。单击 Set (设置)。使用 Point group data 保存唯一标记的数据。导出数据后,程序将显示一个窗口。
- 使用唯一名称来匹配每个感兴趣区域的电流应力前后的测量数据。
注意:此时可以暂停实验。
- 将数据传输到评估软件。
注意:一些激光扫描显微镜具有内置体积测量功能的软件。如果是这种情况,可以选择使用内置软件而不是使用此协议中描述的软件。 - 使用 材料表中 提到的评估软件和 材料表中提到的 软件包版本,然后打开程序(补充编码文件 1:Laserscan_1.vi)。
注意:可以使用其他软件来获得相同的结果。 - 单击 箭头 开始运行程序。单击 Open 打开要使用的 asc 文件的保存路径。通过在选择列表中选择样品的名称,将 asc 文件加载到程序中。确保已选择 area 并单击 cross 和 area。
注意:如果在所选条件下,电迁移发生时间长或样品中的电迁移效应很强,则程序可能无法匹配图像的图案。如果发生这种情况,请在较低的电流密度、更短的测试时间或更低的温度下使用新样品重新进行类似的测量,并相应地调整未来的实验。 - 如果程序与模式不匹配,请手动调整模式匹配。
- 要添加高度比例,请使用鼠标选择属于基板表面的矩形。查看图像中矩形高度的两个直方图,分别位于感兴趣区域图像旁边的电流应力之前和之后。使这两个直方图的形状看起来呈正态分布并尽可能相似。
注意:如果直方图看起来非常不同,请重做所选矩形并稍微改变矩形,直到它对直方图的形状感到满意为止。 - 单击标记为 background 的 零按钮 将此高度保存为背景。
- 在被测线顶部的平面零件上选择另一个矩形。
注意:如果使用此矩形选择的区域在实验期间发生更改,请重做矩形,直到选择没有更改的区域。如果区域变得太小,例如,只有几个像素,则高度的确定将不准确。如果只有一个非常小的区域没有变化,请使用像素较多的图像来获取位于被测行顶部的没有变化的区域。 - 查看感兴趣区域表面图像旁边的两个直方图。使这两个直方图的形状看起来呈正态分布并尽可能相似。
注意:重做创建符合所有条件的矩形,并在直方图中给出良好的结果。 - 通过单击 line under test 并单击 Ok 来保存此值。
注意:此数据目前仅临时保存。 - 单击 红色的停止按钮 停止程序,然后单击 Edit > Make Current Values Default 和 File > Save 将高度参数永久保存到程序中。
注意:程序将背景的高度为 0,将被测线条的高度为 1。这将乘以在后续步骤/最后被测线的测量高度。 - 单击箭头开始运行程序。与前面板相比,用鼠标左键在 IMG 中靠近小丘(或空隙)边缘的地方画一个矩形,从而评估感兴趣区域中的单个小丘(或空隙)。
- 尽可能靠近结构的边缘。使用结构的缩放版本改进所选区域并放大图像,例如,标记为 relax crop 的图像。
- 调整选定的 hillock (或 void) 区域,直到内容与矩形的边缘与 hillock (或 void) 匹配。
- 单击 IMG 比较旁边的 保存按钮 以保存体积的所有像素(积分)的总和。
注意:此时可以暂停实验。 - 继续图像中的下一个 hillock 或 void。对图像中存在的每个小丘(或空隙)执行步骤 2.2.31 到 2.2.34。
注意:在保存每个 hillock(或 void)的积分后,可以暂停实验。 - 使用体积数据并计算小丘(或空隙)的体积总和,以获得在这些条件下一个感兴趣区域中电迁移材料的体积。
- 通过将对应于一个像素(以米为单位)的大小和被测线的高度系数(包括封装层的高度),将确定的总和体积(单位为像素 x 像素 x 高度)转换为立方米 (m³)。
注意:在这项工作中,每个像素为 0.05 μm x 0.05 μm。被测线的高度,包括用于转换的封装层的高度(以立方米为单位),可以使用任何合适的测量技术进行测量。 - 将体积和测量条件(被测线长度、电流密度、温度、电流应力时间)保存为一个数据点。
注意:此时可以暂停实验。
- 使用具有最高分辨率的激光扫描显微镜。
- 按照步骤 2.2 获取更多数据点。对于长度与之前使用的长度不同的被测线,直到至少存在三个电迁移体积不为零的数据点。或者,对于相同长度的线,按照步骤 2.2 获取更多数据点,并稍微改变电流密度。
- 为了获得目标材料和测量条件的临界长度,请制作一个至少包含三个数据点的图表 - 这些数据点不在 x 轴或 y 轴上 - 其中电迁移体积在 y 轴上,长度或电流密度使用在 x 轴上具有不同值的参数。
- 确定数据的最佳拟合线,其中最佳拟合线的 x 轴截距点少于两个。获取小体积数据点的最佳拟合线性线与 x 轴的交点。该交点是 (Ij)c 和 (Ij)c 的 l 或 j,分别通过将截距值乘以实验中使用的电流密度或长度来计算。
注意:根据应力条件、长度和所研究的材料,最佳拟合线可以是接近截流点的线性线,如果电流密度或长度等应力条件较高,则最佳拟合线可以是指数线。
结果
图 1 显示了测试结构几何形状的示意图, 图 2 显示了获取一个数据点所需的测量工作流程示意图。为了研究电迁移开始所需的被测线长度和数值的影响,使用上述协议来获得多条被测线的数据,这些线具有不同的长度(例如,120 μm、540 μm 和 680 μm)由二硅化钼制成,并被一层高温氧化硅封装。所有被测线路均以相同的方式制造,并在室温 (23 °C) 的环境空气条件下以恒定电流施加 7 min 的相同时间应力,在应力下被测线路不会变窄,导致恒定电流密度为 2.26 ×10 10 A/m2、3.25 ×10 10 A/m2 或 3.44 ×10 10 A/m2。
在所使用的测试结构(封装的 MoSi2 线)中,只有 MoSi2 与铝的接触区域显示出体积变化。以前的实验表明,通过封装没有任何类型的突起。
用这种方法评估的所有小丘的横向尺寸都在 200 nm 以上,远高于激光扫描显微镜的横向分辨率。
V = const.lwh
测量体积的最大不确定性可以通过协方差传播定律来估计。

其中 l 是长度,w 是宽度,h 是高度。具有各个尺寸 Δl = 50 nm、Δw = 50 nm 和 Δh = 12 nm 的测量不确定度。长度和宽度的不确定性取一个像素的尺寸。Δh = 12 nm 高度的不确定度是通过 SEM 在激光扫描显微镜可检测到的最小小丘上测量的,并且与制造商声明的不确定度一致。
小丘的高度(如图 3 所示)通常在 190 nm 范围内。最小可正确探测的小丘高度在 34 nm 范围内。对于大多数小山丘,长度和宽度通常在 1 μm 的范围内,如图 3 所示。
这导致具有典型小山丘大小的单个小山丘的不确定性为
 = 16%
= 16%
而一个小山丘
 = 45%。
= 45%。
使用该协议中所示的方法,对几个小山丘的体积求和。一个样品中小丘数量之和的典型值约为 9,如图 3 所示。
这会导致不确定性为:

如果样品中仅存在平均大小的小丘
和

如果样品中存在的所有小丘都非常小。
实际上,样品中存在小而典型大小的小丘,样品之间的小丘数量略有不同,导致不确定性在 5% 到 15% 之间,具体取决于小丘的确切大小和数量。
从这项工作中所示的代表性结果可以看出,电迁移体积的值随着被测线长度的增加而增加。如果应力条件更强,例如使用更高的电流密度值,电迁移体积也会增加。
如果与被测线长度无关的所有体积数据都为零,则电迁移的开始需要更强的应力条件(例如,更高的温度、更长的应力时间、更高的电流密度或这些的组合)。在进一步的实验中将使用更强的应力条件。
图 3 显示了左侧电流应力之前和中间电流应力之后的感兴趣区域。 图 3 的右侧突出显示了电流应力后的小丘。 图 3 显示了新的小丘已经形成,并且在当前应力之前已经存在突起的生长。
图 4 显示了电迁移体积随长度增加的成功结果,包括最佳拟合的指数线,包括所有数据点。 图 4 还显示了用于确定最佳拟合线性线与 x 轴的截距的较短长度的结果。
图 5 显示了电迁移体积随着电流密度的增加而增加的成功数据,长度保持在 120 μm,电流密度在先前实验中观察到的电迁移开始的范围内变化。 图 5 还显示了封装高温氧化硅的影响。两种不同厚度的高温氧化硅(填充圆:60 nm,未填充圆:20 nm)导致电流密度的电迁移开始出现两个不同的值。这是由封装层的机械应力引起的。
图 6 显示了可能可用于初步估计材料中电迁移参数的数据。为了获得更好的结果,应获取更多长度在 150 μm 至 500 μm 范围内的数据。
图 7 显示了次优数据,这需要测试长度在 120 μm 和 260 μm 之间的被测线,因为 120 μm 以上的长度也可能具有 0 的电迁移体积。如果 volume 随着 test structure 长度的增加而减少,则某些数据不正确。很可能是因为体积评估中的错误,例如确定高度刻度的错误或找到小山丘边缘的错误。如果是这种情况,可以再看一遍相应图像的评估并重新评估,以找出问题的根源。
错误的数据也可能是由于没有让测试结构冷却到室温以进行第二次扫描。再次扫描同一区域并使用新的扫描进行评估是解决此问题的唯一选项。如果在重新评估并重新进行扫描后此问题仍然存在,则可能不是由评估中的错误引起的,并且可能是所用材料的实际影响。
对于略高于临界长度的长度,最佳拟合线可以用直线近似。如果待测线的长度变长,则最佳拟合线的指数性质将变得可见。
在电流密度为 3.25 ×10 10 A/m2 的电流密度下,x 轴的截距确定为 33.33 μm,导致 (Ij)c =1.08 × 106 A/m。
根据 图 5 的数据,截距确定为 3.49 ×10 10 A/m2 和 3.6 ×10 10 A/m2。当被测线的长度为 120 μm 时,这些值为 4.19 × 106 A/m 和 4.2 × 1010 A/m。
被测关键产品的差异是由于被测线路的自热增加而电流密度增加引起的。被测线路的温度通常随着电流密度的增加而升高。通过测量电流密度为 2.65 × 1010 A/m2、3.24 × 1010 A/m2、3.53 ×10 10 A/m2 和 3.85 × 1010 A/m2 为 158 °C 的电流密度,确定受压 7 min 的被测线路的温度, 分别为 202 °C、257 °C 和 320 °C。关键乘积对温度和其他因素的依赖性在11 之前已经显示。
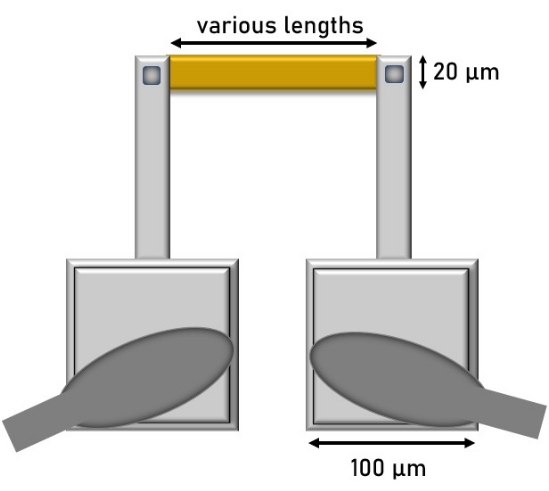
图 1:适合通过激光扫描显微镜研究电迁移参数的测试结构几何形状示意图。 金盒是被测线(在本作品中由 MoSi2 制成),银盒是电源(在本作品中由铝制成),接触垫在键合线区域(深灰色)显示为银盒的堆叠。堆栈表明接触焊盘的层厚高于电源的层厚。被测线路两侧的小银框是电源和被测线路的电气接触区域。暗边缘应该象征着该区域具有较低的高程,因为封装层在此部分打开以实现电接触。 请单击此处查看此图的较大版本。

图 2:获取一个数据点所需的测量工作流程示意图。请单击此处查看此图的较大版本。
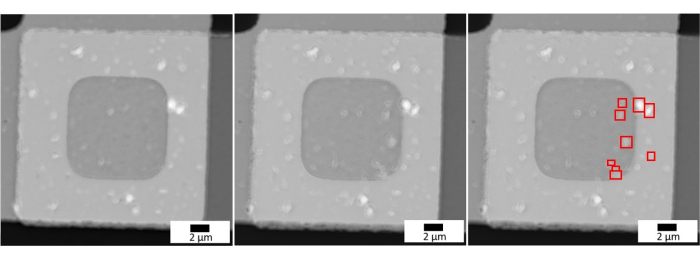
图 3:电流应力前后感兴趣区域的比较。 电流应力之前(左侧)和电流应力后(中间)的感兴趣区域(在这项工作中,铝与被测线的电接触)与右侧突出显示的电迁移引起的小丘的比较。 请单击此处查看此图的较大版本。

图 4:阴极侧接触区的电迁移体积的成功结果,具体取决于 MoSi2 线的被测线长度。 阴极侧接触区电迁移体积的代表性数据(成功结果)取决于被测线的长度 对于封装有 60 nm 高温氧化硅的 MoSi2 线,在环境空气条件下应力 7 分钟,电流密度为 3.25 ×10 10 A/m2。 请单击此处查看此图的较大版本。
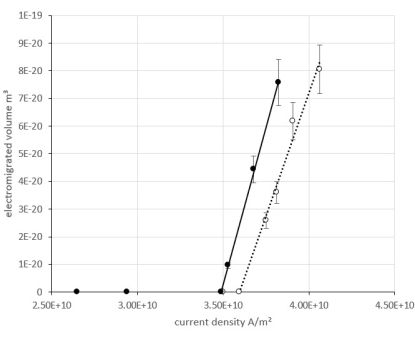
图 5:阴极侧接触区的电迁移体积取决于 MoSi2 封装线的电流密度的成功结果。阴极侧接触区电迁移体积的代表性数据(成功结果)取决于被测 MoSi2 封装线的电流密度,同时在环境空气条件下受压 7 分钟。实心圆圈显示了用 60 nm 高温氧化硅封装的被测 MoSi2 线的数据。未填充的圆圈显示了用 20 nm 高温氧化硅封装的被测 MoSi2 线的数据。请单击此处查看此图的较大版本。

图 6:有效数据。 阴极侧接触区电迁移体积的代表性数据(数据可以使用)取决于封装有 60 nm 高温氧化硅的 MoSi2 线的被测线的长度,在环境空气条件下应力 7 分钟,电流密度为 2.56 ×10 10 A/m2。 请单击此处查看此图的较大版本。

图 7:次优数据。 阴极侧接触区电迁移体积的代表性数据(次优数据)取决于被测线的长度,对于封装有 20 nm 高温氧化硅的 MoSi2 线,在环境空气条件下以 3.44 ×10 10 A/m2 的电流密度。 请单击此处查看此图的较大版本。
补充编码文件 1:Laserscan_1.vi.请点击此处下载此文件。
讨论
此处概述的协议可用于稳健且可重复地获取有关导电材料电迁移体积的数据。可用的材料和设备必须满足某些标准,如上文在协议步骤或“NOTEs”中提到的,以便能够使用这种方法来评估电迁移。
该方案的关键部分是确保样品在电流应力后冷却至室温以进行测量。由于扫描过程中的温度变化,如果不冷却到室温,会给表面扫描带来误差,并给出错误的表面确定,因此,体积的确定有错误。
另一个重要部分是选择足够的背景和被测线的高度,以确定评估程序中的高度因子。如果作不正确,则音量将错误。其他关键部分是测量至少三个样品,这些样品的体积值不为零。
如果在当前应力后扫描的数据看起来不好,并且在进行评估之前没有被注意到,则可以使用与第一次扫描相同的参数再次扫描。如有必要,请确保能够避免转动样品,方法是像以前一样在激光扫描显微镜下对准样品,或者通过软件进行校正。有关其他故障排除方法,请查看说明。
该方法的修改涉及对样品使用加热台,类似于采用加热台11 的其他实验方法,将样品从样品架中取出以在不同条件下进行应力处理,例如在烘箱或其他周围介质(液体或气体)中的高温,这在样品在激光扫描显微镜下时无法完成。
在不同条件(例如温度)下的测量使得使用这种确定体积的方法可用于计算其他电迁移参数,例如有效离子电荷或活化能。有效离子电荷的计算使用电迁移体积作为起点。体积的确定方法对于计算并不重要。计算方法与使用通过 SEM 测量的电迁移体积确定有效离子电荷的方式相同 2,3,4.
如前面的方程中所述,电迁移体积取决于扩散。扩散呈指数级取决于特定过程的活化能12.这允许使用 over 的 Arrhenius 图从线性斜率获得活化能。该方法还可用于确定 Blech 结构中的体积变化,并按照与通过 SEM11 确定的体积相同的方式计算漂移速度。
只有当表面的激光扫描可以接触到小丘或空隙时,才能使用此方法。这使得该方法不适合评估由浸没空隙引起的体积变化。激光扫描显微镜对体积变化的敏感度低于通过 SEM 和 TEM 可检测到的最小变化。如果电迁移体积太小,使用激光扫描显微镜不会给出任何有用的结果。
与使用 SEM 或 TEM 进行研究相比,在激光扫描显微镜的设置中加入加热台更容易,因为它们通常必须定制 7,11,13,14。
披露声明
作者没有什么可披露的。
致谢
这项研究由“德国联邦经济事务和气候行动部”资助,项目“EMIR”资助代码 49MF190017。
材料
| Name | Company | Catalog Number | Comments |
| Current source/2602B System Source Meter | Keithley | 2602B | Any type of current source can be used. |
| JKI VI Package Manager | NI | 781838-35 | https://www.ni.com/de-de/shop/product/jki-vi-package-manager.html? srsltid=AfmBOorzYPY4B8 hlGIUIYl3PJoBwb8o8PeV MsBfM9YcFasnBIhEWwBpd |
| Labview 2024 Q1 Full | NI | 784522-35 | Evaluation software option (https://www.ni.com/de-de/shop/product/labview.html?partNumber=784522-35) |
| Labview 2024 Q1 Pro | NI | 784584-35 | Evaluation software option (https://www.ni.com/de-de/shop/product/labview.html?partNumber=784522-35) |
| Laser scanning micrsoscope VK-X200 series | Keyence | VK-X200 no longer available for purchase. Available option VK-X3100. Laser scanning microscope with wavelength of 408 nm. | |
| NI Vision Development Module | NI | 788427-35 | https://www.ni.com/de-de/shop/product/vision-development-module.html?srsltid=AfmBOoq2S8kYVmV1CK6 xSovMHTELtQHE2neD oM2RrEnibd2AuyzkWvuS |
| Objective lens, CF Plan Apo 150x/ 0.95; ∞/0 EPI; OFN25 WD 0.2 | Nikon | BZ10123016 | https://spwindustrial.com/nikon-cf-plan-apo-150x-0-95-0-wd-0-2mm-epi-objective/ |
| VK Analyse-Modul Version 3.3.0.0 | Keyence | Analytics software supported by the laser scanning microscope. No longer available for purchase. New laser scanning microscope uses newer software. | |
| VK Viewer Version 2.2.0.0 | Keyence | Measurement software supported by the laser scanning microscope. No longer available for purchase. New laser scanning microscope uses newer software. |
参考文献
- Somaiah, N., Kumar, P. Inverse blech length phenomenon in thin-film stripes. Phys Rev Appl. 10 (5), 054052(2018).
- Huynh, Q. T., Liu, C. Y., Chen, C., Tu, K. N. Electromigration in eutectic SnPb solder lines. J Appl Phys. 89 (8), 4332-4335 (2001).
- Lee, T. Y., Tu, K. N., Kuo, S. M., Frear, D. R. Electromigration of eutectic SnPb solder interconnects for flip chip technology. J Appl Phys. 89 (6), 3189-3193 (2001).
- Lee, T. Y., Tu, K. N., Frear, D. R. Electromigration of eutectic SnPb and SnAg3.8Cu0.7 flip chip solder bumps and under-bump metallization. J Appl Phys. 90 (9), 4502-4508 (2001).
- Ho, C. E., Hsieh, W. Z., Yang, C. H., Lee, P. T. Real-time study of electromigration in Sn blech structure. Appl Surf Sci. 388, 339-344 (2016).
- Chang, Y. W., et al. Study of electromigration-induced formation of discrete voids in flipchip solder joints by in-situ 3D laminography observation and finite element modeling. Acta Mater. 117, 100-110 (2016).
- Besser, P. R., Madden, M. C., Flinn, P. A. In situ scanning electron microscopy observation of the dynamic behavior of electromigration voids in passivated aluminum lines. J Appl Phys. 72 (8), 3792-3797 (1992).
- Doan, J. C., Lee, S. -H., Bravman, J. C., Flinn, P. A., Marieb, T. N. Void nucleation on intentionally added defects in Al interconnects. Appl Phys Lett. 75 (5), 633-635 (1999).
- Kelly, M. B., Niverty, S., Chawla, N. Electromigration in bi-crystal pure Sn solder joints: elucidating the role of grain orientation. J Alloys Compd. 818, 152918(2020).
- Influences of the microstructure on the drift velocity of electromigrating aluminum through molybdenum disilicide thin films. Schädel, M., Baldauf, J. SMSI 2021 Conference - Sensor and Measurement Science International, , (2021).
- Straub, A. Factors Influencing the Critical Product in Electromigration. , University of Stuttgart, Stuttgart. (2000).
- Scorzoni, A., Neri, B., Caprile, C., Fantini, F. Electromigration in thin-film interconnection lines: models, methods and results. Mater Sci Rep. 7 (4-5), 143-220 (1991).
- Verma, S. K., Raynaud, G. M., Rapp, R. A. Hot-stage scanning electron microscope for high-temperature in-situ oxidation studies. Oxid Met. 15 (5/6), 471-483 (1981).
- Heard, R., Huber, J. E., Siviour, C., Edwards, G., WilliamsonBrown, E., Dragnevski, K. An investigation into experimental in situ scanning electron microscope (SEM) imaging at high temperature. Rev Sci Instrum. 91 (6), 063702-063814 (2020).
转载和许可
请求许可使用此 JoVE 文章的文本或图形
请求许可探索更多文章
This article has been published
Video Coming Soon
版权所属 © 2025 MyJoVE 公司版权所有,本公司不涉及任何医疗业务和医疗服务。